本研究成果のポイント
- ビスマス(Bi)系III-V族半導体半金属混晶の一つであるGaAsBi(砒化ガリウムビスマス)の生成において、生成時に使用する半導体基板の温度を180℃と250℃にそれぞれ設定するだけで、非晶質層と単結晶層を作り分けることに成功しました。
- 生成時のGaとAsの分子線量比率を精緻に調整することで、Bi原子が均一に取り込まれた非晶質GaAsBiと単結晶GaAsBiが得られることが明らかになりました。
- 250℃という半導体の生成温度としては低い温度を用いても、原子配列の乱れが極力少ない単結晶GaAsBiが得られることがわかり、これにより、低温生成時に結晶欠陥が減少するようにBi原子が発揮する効果の解明や、少ないながらも結晶内に存在する結晶欠陥を生かした半導体デバイスの実現に繋がることが期待されます。
概要
広島大学大学院先進理工系科学研究科の富永依里子准教授は、広島大学ナノデバイス・バイオ融合科学研究所技術職員の西山文隆氏、愛媛大学大学院理工学研究科の石川史太郎准教授との共同研究において、比較的新奇なGaAsBi(砒化ガリウムビスマス)というBi系III-V族半導体半金属混晶の一つを分子線エピタキシー(MBE)法によって生成する際、半導体基板の温度を、180℃と250℃にそれぞれ設定するだけで、非晶質層と単結晶層を作り分けることに成功しました。MBE法による生成時のGaとAsの分子線量比率を精緻に調整することで、Bi原子が均一に取り込まれた非晶質GaAsBiと単結晶GaAsBiが得られることがラザフォード後方散乱法による測定から明らかになりました。また、250℃という半導体結晶の生成温度としては低い温度を用いても、原子配列の乱れが極力少ない単結晶GaAsBiが得られることがX線回折法からわかりました。今回得た試料を詳細に分析したり、割り出した結晶生成条件を活用したりすることで、低温生成時に結晶欠陥が減少するようにBi原子が発揮するいわゆるサーファクタント効果の解明や、少ないながらも結晶内に存在する結晶欠陥を生かした半導体デバイスの開発が前進することが期待されます。この研究成果は、3月23日に、応用物理学会が発行する国際レター誌「Applied Physics Express」にてオンライン公開されました。
発表内容
【背景】
Bi原子は原子半径が他の元素に比べて大きいことから、GaAsやInAsのような旧来の半導体結晶に取り込むと結晶の構成元素の周期配列を歪ませます。このためBi原子を数パーセント取り込んだだけで、GaAsBiやInAsBiのようなBi系III-V族半導体半金属混晶(以下、Bi系III-V族半導体)は①禁制帯(注1)幅が急激に小さくなる、②価電子帯上端が高エネルギーシフトする、③禁制帯幅の温度依存性が低減するという3つの特異な物性を発現します。また、Bi原子の大きなスピン軌道相互作用によってBi系III-V族半導体の価電子帯頂上とスプリットオフバンド間のエネルギーが大きくなることも知られています。これらの興味深い基礎特性から、Bi系III-V族半導体は、光通信用半導体レーザ、近赤外・中赤外光検出器、高効率太陽電池、スピントロニクスデバイスなどの半導体デバイスへの新規応用が提案され、特にここ10年ほどで国内外で盛んに研究が進められるようになった比較的新しい化合物半導体です(図1)。一方でBi原子は、400˚C以下の生成温度でなければGaAsなどの母体結晶に取り込まれないこと、そして生成温度を下げるほどBi組成(例:GaAs1-xBixのx)が増加して禁制帯が母体結晶のものよりも小さくなることが実験的に明らかになっています(図1)。GaAs系III-V族半導体の一般的な成長温度が600˚C付近であることを考えますと、Bi系III-V族半導体は元来低温生成が必要であると言えます。これは即ち、Bi系III-V族半導体は、結晶欠陥(注2)が結晶内に形成されやすいことを意味しています。つまり、Bi系III-V族半導体の基礎特性は興味深いが、結晶内の結晶欠陥が存在するため、半導体デバイス品質の結晶を得ることは難しいと容易に予想される、ジレンマを抱えた半導体と言えます。
そこで広島大学の富永准教授は、この低温生成によって形成される結晶欠陥を排除するのではなく、逆転の発想で活用しようと、Bi系III-V族半導体の新しい応用先としてテラヘルツ(THz)波発生検出素子用の光伝導アンテナに着目し、これまで分子線エピタキシー(MBE)法(注3)を用いたGaAsBiの低温領域での生成(以後、結晶成長や成長)に取り組んできました。THz波の発生検出特性を向上させた光伝導アンテナを実現するには、結晶品質を劣化させ過ぎない程度に結晶欠陥を程よく結晶内に取り込む必要があります。
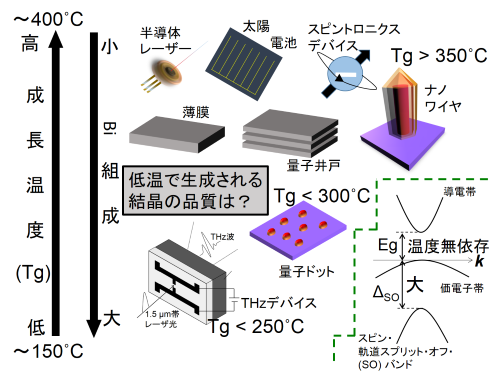
図1 Bi系III-V族半導体の特徴や薄膜・量子/ナノ構造の成長温度、Bi組成の相関の概観図。
【内容】
一般に半導体結晶は、結晶欠陥や不純物を結晶成長中に取り込むことを避けるため、高温で成長させます。低温成長では、成長中の結晶の最表面で半導体の構成元素が自由に動きにくくなり、結晶欠陥が増えるためです。本研究では、THz波発生検出用光伝導アンテナの動作特性に適したGaAsBiを得るため、意図的に低温成長を行い、結晶欠陥を程よく結晶内に取り込むためのMBE成長を試みました。GaAsBiのMBE成長時に使用するGaAs基板の温度を180℃に設定した際、GaAsBiを成長させるときに照射するGa、As、Biの各分子線のうちGaとAsの分子線量比率をGaとAsの原子数比に換算しました。その原子数比(NAs/NGa)が1を下回る場合には、Biが試料表面に偏析し、均質なGaAsBiは成長できず、かつ試料の表面にGa液滴が形成されることが明らかになりました(図2左)。一方、NAs/NGaが1より大きくなると、GaAs基板の温度が180℃の場合にはBiの組成に大きな揺らぎのない非晶質(注4)GaAsBiが堆積し(図2右)、基板の温度が250℃の場合には低温成長にもかかわらず単結晶(注5)GaAsBiが成長することがラザフォード後方散乱法(注6)による測定からわかりました。低温成長であっても、成長表面のGaとAsの原子数を1 : 1に保つ必要性は従来のGaAs系半導体のMBE成長の基本原則と変わらず、その比率の範囲内でBi原子がGaAs結晶内に均一に取り込まれるMBE成長条件を選択することが重要と言えます。また、NAs/NGaを適切に設定することで、基板温度を変化させるだけで非晶質層と単結晶層の作り分けが可能であることを示した成果であるとも言えます。更に、250℃という半導体結晶の成長温度としては低温を用いても、原子配列の乱れが極力少ない単結晶GaAsBiが得られることが、試料のX線回折(注7)カーブの干渉フリンジから判断できました。以上の試料は愛媛大学のMBE装置で成長し、測定は広島大学工学部のラザフォード後方散乱測定装置をはじめ、広島大学自然科学研究支援開発センターや同大学ナノデバイス・バイオ融合科学研究所所有の装置によって行いました。
本研究は、広島大学大学院先進理工系科学研究科の富永依里子准教授、広島大学ナノデバイス・バイオ融合科学研究所技術職員の西山文隆氏、愛媛大学大学院理工学研究科の石川史太郎准教授の共同研究によるものです。
本研究は、日本学術振興会科学研究費助成事業の基盤研究B(研究課題番号:21H01829)、新学術領域研究(研究領域提案型)公募研究(研究課題番号:19H04548)、若手研究(研究課題番号:18K14140)、池谷科学技術振興財団単年度研究助成(研究課題「ビスマス系Ⅲ-Ⅴ族半導体超格子の欠陥制御に基づく新規THzデバイスの実現」)、文部科学省ナノテクノロジープラットフォーム事業(課題番号:F-18-RO-0034、F-19-RO-0018、F-19-RO-0027)などの支援を受けて実施されました。
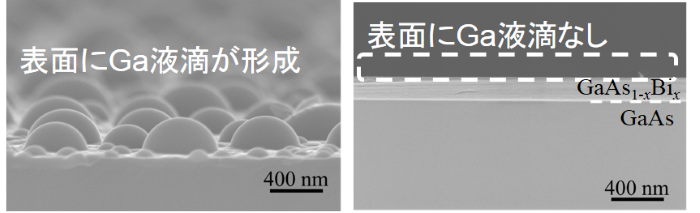
図2 今回成長した試料の表面の走査型電子顕微鏡像。MBE成長時のGaとAsの原子数比(NAs/NGa)が1を下回る場合(左)と1より大きい場合(右)。
【今後の展開】
富永准教授は、今回得られた低温成長GaAsBi試料とMBE成長条件を活用し、結晶内の点欠陥の密度や原子配置を明らかにする研究を既に開始しています(日本学術振興会科学研究費助成事業:基盤研究B(研究課題番号:21H01829)・学術変革領域研究(A) 公募研究(研究課題番号:21H05566))。今後は、Bi原子が低温成長中に発揮している効果ならびに結晶内の欠陥や原子分布がGaAsBiの機能発現にどのように寄与しているのかなどが明らかになることが期待されます。また、低温成長GaAsBiを用いて光伝導アンテナを作製し、THz波の発生検出特性を明らかにすることで、Bi系III-V族半導体の結晶欠陥を活用した半導体デバイス応用が展開されていくことも期待できます。
用語解説
(注1)禁制帯
結晶を構成している原子の数は非常に多いため、原子の核外電子のエネルギー準位が相互作用によって原子の数に相当する準位に分離し、この分離した準位が重なってほぼ連続的に分布し、エネルギー帯を形成する。この内、電子が存在することのできるエネルギー帯を許容帯、許容帯と許容帯の間の電子が存在できない範囲を禁制帯と呼ぶ。
(注2)結晶欠陥
結晶内で原子が完全な規則的配列をしておらず、その配列に抜けやずれがあったり、表面などに特異な状態ができたりしていることの総称。
(注3)分子線エピタキシー(MBE)法
超高真空中で、基板温度を成長温度に加熱し、成長したい結晶の構成元素の蒸発分子を分子線として基板に向けて蒸発させ、基板上に単結晶を成長する方法。
(注4)非晶質
固体の内、原子または分子が不規則に配列しているもの。
(注5)単結晶
固体の内、原子または分子が規則的に配列して結晶となっており、結晶全体が一つの結晶であるもののこと。
(注6)ラザフォード後方散乱法
Heイオンのような軽いイオンを数MeV程度の高エネルギーに加速し、測定対象試料に照射する。この時の原子核によって後方に散乱されたイオンのエネルギースペクトルを測定することで試料中の元素分析を行う方法。
(注7)X線回折
結晶に、その結晶の構成原子や分子の間隔と同程度の波長をもったX線を入射させると、X線がその原子や分子で散乱し、ある特定の方向で干渉し合うことで強いX線が観察される。このX線の回折現象のこと。
論文情報
- 掲載誌: Applied Physics Express
- 論文タイトル: Crystalline quality of GaAs1−xBix grown below 250˚C using molecular beam epitaxy
- 著者名: Yoriko Tominaga, Yukihiro Horita, Yuto Takagaki, Fumitaka Nishiyama, Mitsuki Yukimune and Fumitaro Ishikawa
- DOI: 10.35848/1882-0786/ac5ba5
【お問い合わせ先】
<研究に関すること>
広島大学大学院先進理工系科学研究科
准教授 富永 依里子
Tel:082-424-7049
Fax:082-424-7649
E-mail:ytominag*hiroshima-u.ac.jp
愛媛大学大学院理工学研究科
准教授 石川 史太郎
Tel:089-927-9765
E-mail:ishikawa.fumitaro.zc*ehime-u.ac.jp
<広報に関すること>
広島大学財務・総務室広報部広報グループ
Tel:082-424-3749
Fax:082-424-6040
E-mail:koho*office.hiroshima-u.ac.jp
愛媛大学総務部広報課広報チーム
Tel:089-927-9022
Fax:089-927-9052
E-mail:koho*stu.ehime-u.ac.jp
(注: *は半角@に置き換えてください)

 Home
Home